在我们日常的PCBA加工中,BGA的全称是Ball Grid Array(焊球阵列封装),它是在封装体基板的底部制作阵列焊球作为电路的I/O端与印刷线路板(PCB)互接。采用该项技术封装的器件是一种表面贴装器件。它是集成电路采用有机载板的一种封装法。为了能够确定和控制这样一种工艺过程的质量,要求了解和测试影响其长期工作可靠性的物理因素,例如:焊料量、导线与焊盘的定位情况,以及润湿性等。
BGA器件的性能和组装优于常规的元器件,但是许多生产厂家仍然不愿意投资开发大批量生产BGA器件的能力。究其原因主要是BGA器件焊接点的测试相当困难,不容易保证其质量和可靠性。
在当今信息时代,随着电子工业的迅猛发展,计算机、移动电话等产品日益普及。人们对电子产品的功能要求越来越多、对性能要求越来越强,而体积要求却越来越小、重量要求越来越轻。这就促使电子产品向多功能、高性能和小型化、轻型化方向发展。为实现这一目标,IC芯片的特征尺寸就要越来越小,复杂程度不断增加,于是,电路的I/O数就会越来越多,封装的I/O密度就会不断增加。为了适应这一发展要求,一些先进的高密度封装技术应运而生,BGA封装技术就是其中之一。
BGA封装出现于90年代初期,现已发展成为一项成熟的高密度封装技术。在半导体IC的所有封装类型中,1996~2001年这5年期间,BGA封装的增长速度最快。在1999年,BGA的产量约为10亿只。但是,到目前为止,该技术仅限于高密度、高性能器件的封装,而且该技术仍朝着细节距、高I/O端数方向发展。BGA封装技术主要适用于PC芯片组、微处理器/控制器、ASIC、门阵、存储器、DSP、PDA、PLD等器件的封装。
PCBA加工中BGA封装的特点:
1、封装面积少;
2、功能加大,引脚数目增多;
3、PCB板溶焊时能自我居中,易上锡;
4、可靠性高,电性能好,整体成本低。
PCBA加工有BGA的PCB板一般小孔较多,大多数客户BGA下过孔设计为成品孔直径8~12mil,BGA处表面贴到孔的距离以规格为31.5mil为例,一般不小于10.5mil。BGA下过孔需塞孔,BGA焊盘不允许上油墨,BGA焊盘上不钻孔。
PCBA加工中BGA器件在使用常规的SMT工艺规程和设备进行组装生产时,能够始终如一地实现缺陷率小于20(PPM)。SMT技术进入90年代以来,走向了成熟的阶段,但随着电子产品向便据式/小型化、网络化和多媒体化方向的迅速发展,对电子组装技术提出了更高的要求,新的高密度组装技术不断涌现,其中BGA(Ball Grid Array球栅阵列封装)就是一项已经进入实用化阶段的高密度组装技术。
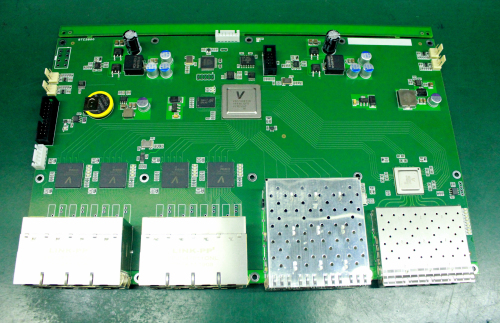
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。